
Kulicke & Soffa scoort met goedkoop alternatief voor hybrid bonding
De Singaporese backend machinebouwer Kulicke & Soffa zegt dat meerdere klanten in de assemblagemarkt zijn Aptura thermocompressieplatform hebben geselecteerd. Thermo-compressie bonding (TCB) is een techniek waarbij chips direct met elkaar worden verbonden middels soldeerheuveltjes (bumps) van enkele tientallen micrometers. De pitch in geavanceerde chipverpakkingen ligt momenteel tussen de 25 en 80 micrometer. Het verkleinen van deze afstand is de uitdaging bij het ontwikkelen van beter presterende en energiezuinige systemen. Vooral AI is momenteel de grote drijvende kracht van technologieën.
Soldeertin
In een conventioneel thermo-compressie verbindingsproces plaatst men chips op (silicium)substraten zoals zogenaamde interposers of op andere chips die nog deel uitmaken van een wafer. Daarvoor moeten de verbindingsvlakken aan beide zijden worden natgemaakt met soldeertin. Kleine druppels metaal blijven dan als een bolletje op de koperen verbindingsvlakken plakken. Daarna kan de boel onder toevoeging van druk en temperatuur met elkaar worden verbonden (met ultrasoon trillen).
Bij een pitch van minder dan 50 micron is dit een behoorlijke uitdaging, omdat er voor het noodzakelijk verwijderen van het laatste tinresidu hoge temperaturen nodig zijn. Dat is vooral problematisch bij geheugens en dat zijn nu net de chips die fabrikanten in grote aantallen willen verbinden. DRAM-stacks voor high bandwidth memory (HBM) bevatten twaalf lagen; in de toekomst wil men graag naar zestien.
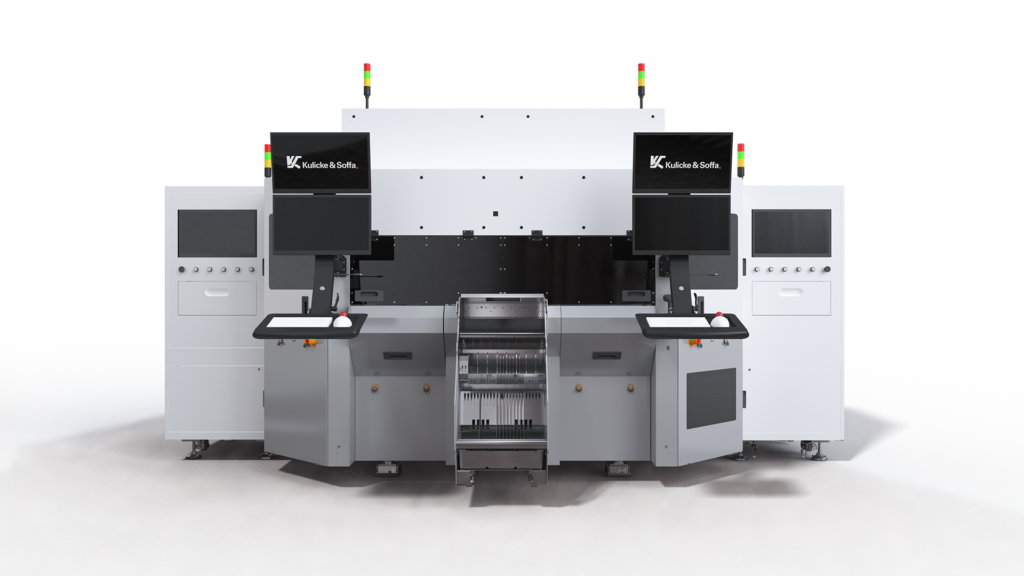
Fluxless
Kulicke & Soffa ontwikkelde een technologie zonder soldeerflow (fluxless) dat het opwarmen van de substraatwafer tot een minimum beperkt. In dit proces bevatten alleen de geplaatste chips soldeerbolletjes. Om geen last te hebben van oxidevorming op de tegenoverliggende kopervlakken blaast men mierenzuur over het substraat. Dat alles in een stikstofomgeving.
Deze gepatenteerde fluxloze TCB-technologie richtte K&S in de eerste plaats op soldeergebaseerde toepassingen met pitches tussen de 12 en 80 micrometer, het bedrijf zegt dat de technologie ook directe koper-koperverbindingen mogelijk maakt. ‘Wij geloven dat onze] koper-koper TCB interconnectie-oplossing grote voordelen biedt tussen ongeveer 5 - 20 µm pitch’, schrijft Adeel Bajwa van K&S [op 3D InCites.
Tijdens de bespreking van de afgelopen kwartaalcijfers met analisten liet ceo Fusen Chen weten dat de dochteronderneming van een groot halfgeleiderconcern inmiddels heeft aangetoond dat fluxless thermocompressie werkt voor directe koper-koperverbindingen. Chen wees erop dat de technologie daarmee kan worden gezien als een variant van hybrid bonding, waarbij de diëlektrica en koperpads van chips direct met elkaar worden verbonden. Besi is voorloper in deze systemen. Chen wijst erop dat K&S’ Aptura-machines veel minder investeringen vereisen dan bestaande chip-naar-wafer hybride oplossingen (lees: de systemen van Applied Materials en Besi die beide nodig zijn voor hybrid bonding).





